C-DIC(Кръгов диференциаленинтерферентен контраст)вотразена светлина
Автор: Том Калахан
Carl Zeiss Microscopy LLC USA
Конвенционалният диференциален интерферентен контраст (DIC), или понякога наричан контраст по Номарски, е известен от много години в микроскопията с отразена светлина. С тази контрастираща техника се постига високо чувствително релефно изображение (Фиг. 1b) на топографията на повърхността на образеца в нанометричен обхват. Неудобството на тази техника е, че тя зависи от направлението (азимута) и може да бъде подвеждаща и да не представи най-доброто изображение в зависимост от ориентацията на образеца, ако не се приложи трудно и отнемащо време завъртане на образеца.
Едно уникално решение на ZEISS, кръгов диференциален интерферентен контраст (C-DIC), спомага за избягването на горепосочения недостатък, като оптимизира бързо и лесно изображението без да се губят ценни детайли от него, без да се върти образеца, като контрастът и резолюцията се подобряват.
Figure. 1 – Метализиран слой върху диелектричен слой. DIC (C-DIC) позволява да се види топографията и текстурата на метализацията и на долния диелектричен слой, които не са забелязват в светло поле.

Фигура 2
За да се разберат възможностите и ползата от C-DIC,първо трябва да направим кратко изложение за възможностите на конвенционалнияDICи получения контраст в изображението. Диференциалният интерферентен контраст(DIC)е най простия метод за визуализиране на топографията на повърхността, и по-специално на наклонени участъци, вдлъбнатини и другинехомогенности.
При DICлинейно поляризираната светлина се разделяна два ортогоналнополяризирани лъча. DICпризмата(два специално клиновидно изрязани оптични елемента, залепени един към друг – Fig.2),е оптичният елемент, който разделяполяризираната светлина на тези два ортогонални лъча.Двата лъча са страничноотместени от призмата върху повърхността на образеца.Това отместване “S”(наричано също срязване)е “диференциално”малко(суб-резолюция на обектива).Стойността на отместването влияе върхуконтраста на изображението и резолюцията (Fig.2).
Направлениетона това отместване върху образеца зависи от поляризатора.Стойността на отместването може да създаде високконтраст на изображението (голямо отместване)или висока резолюция(малко отместване).Когато повърхността на образеца има разлика във височината и/или индекса на пречупване,единият лъч изминава по-дълъг път от другия лъч,структурното изменение предизвиква разлика в пътя имили фазово отместване в посока Z.Призмата предизвикваотносително фазово отместване във всеки лъч, което също допринася за тази“разлика в оптичния път”.Степента на фазово отместванесе изменя от положението на лъча по отношение на клина впризмата.Така призмата може да бъде придвижвана странично (което е възможно и при C-DIC)по направление на клина(това е познато катоклиново закъснение), за да подпомогне регулирането на разликата в пътищата на ортогоналнителъчи. Потози начин изображениетоизглеждакато засенчено, като че ли е осветено едностранно (по направлението на отместване).
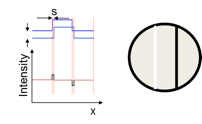
Фигура 3
След отразяване от образеца, преминаване отново през призматаи рекомбиниране,тези дваортогонални лъча достигат друг поляризатор, който се нарича “анализатор”.Тук тези два лъча интерферират исъздават изображението.Това рекомбиниране води до конструктивна и деконструктивна“интерференция”, която причинява промяна в интензивността на изображениетотам, къдетодвете оптични пътеки са различни (Fig.3). Изображението тогаваима вид на три-дименсионен обект,осветен косо, със светли и тъмни сенки на съответнитевертикални повърхности.Направлението на истинското осветление се показва от ориентацията на отместването на призмата.
След създаването на интерферентния контраст,характеристиките на образеца (промяна във височината)трябва да бъдат перпендикулярникъм направлението на отместване за получаване на максимален контраст.
Ако промяната във височинатае успоредна на отместването, тя ще има минимален контраст или изобщо няма да се вижда.
Максимуми в контраста могат да се очакват само в едно предпочитателно направление,а именно в направлението на отместване. Изменението на ориентацията на характеристиките на образеца щеизменя и възможността те да бъдат визуализирани (Fig. 4).

Фигура 4
Следователно,образецът трябва да бъде завъртян на азимут (хоризонтална ротация),за да може да се получи най-добрата информация. Това би поставило изисквания за прецизна ротация на масичката, което обикновено не е възможно, а ръчното завъртанеби било безуспешно, още повече че при големи увеличения изображението може да изчезне от зрителното поле.
На фиг.4 е показано влиянието на направлението на отместване. В зависимост от ориентацията,информациятаможе да бъде загубена и това да доведе до грешна интерпретация на характеристиките на образеца.
Решението на ZEISS за “направлението на отместване”е уникалната контрастираща техниказа кръгов диференциален интерферентен контраст(C-DIC).C-DICизползва“кръгово поляризирана светлина”вместо линейно поляризираната, използвана при обикновената DICтехника. Кръгово поляризираната светлина се получава от вмъкването на перфектно съосни пластинки с дебелина ¼ дължина на вълната в поляризатора и анализатора. Това произвежда един ефект подобен на тирбушон върху поляризацията. Кръговата поляризация позволява ротация на “призмата”, а оттам и на направлениетона отместване, докато образецът е неподвижен!За потребителя това дава повече информация,увеличаване броя на изследванията и улесняване на работата.
Ротацията на C-DIC призмата не само позволява визуализация на характеристики, които стандартният DIC анализ може да пропусне, но и позволява оптимизация на контраста и резолюцията на изображението.
Малка разлика в направлението може да увеличи или намали контраста на топографските характеристики. Намаляването на отместването намалява контраста и увеличава резолюцията. Както може да се види от Фиг.5в направление на отместване от 45 градуса върху този обект предизвиква еднакво отместване и в двете направления X и Y.
Промяната на този ъгъл във Фиг. 5a предизвиква по-голямо отместване и контраст по направление Y и по-малко отместване и контраст по направление X. С по-малко отместване по X резолюцията се повишава в това направление. На Фиг . 5c контрастът и резолюцията се променят по X и Y в сравнение с Фиг. 5а.
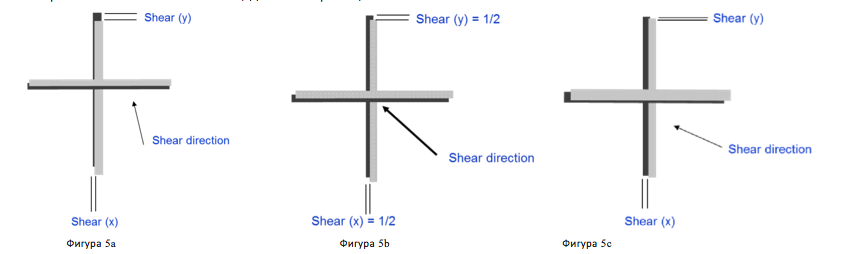
При конвенционалния DIC образецът трябва да се завъртаза постигане на най-добро изображение.
Уникалната техника на ZEISSC-DIC дава възможностда се оптимизира изображението без участие на образеца.

Фигура 6 Кварцова пластинка с дебелина 20nm с дълбоко разядени канали (оптичен водач) / 50x обектив. C-DIC може да произведе оптично изображение независимо от ориентацията на структурата.
За тази уникална техника на ZEISS за кръгов диференциален интерферентен контраст се използват същите компоненти както за стандартния DIC, които могат да бъдат просто монтирани в повечето прави или инвертни микроскопи с отразена светлина. Техниката изисква C-DIC модул за отразена светлина и C-DIC Prism. Модулът за отразена светлина (Фиг. 7a) се състои от поляризатор & пластинка с дебелина ¼ дължина на вълната, 45 градуса частично огледало и анализатор & пластинка с дебелина ¼ дължина на вълната (подобна на Фиг. 2). Потребителят може да монтира този модул чрез просто поставяне на място в микроскопа. Призмите могат да бъдат или от типа с просто плъзгане (Фиг. 7b) с бутон за въртене на призмата или от револверен тип (Фиг. 7c). Те могат да бъдат ръчни или моторизирани за постигане на по-голяма степен на автоматизиране в зависимост от вида и конфигурацията на микроскопа.

Обобщение:
- Отпада необходимостта от въртене на образеца, което отнема много времеи в повечетослучаи е трудно или невъзможно.
- Няма липсваща или грешно интерпретирана информация за характеристикитена повърхността.
- Контрол на контраста и резолюцията.
- По-ниска цена отколкото стандартнияDICв някои случаи..
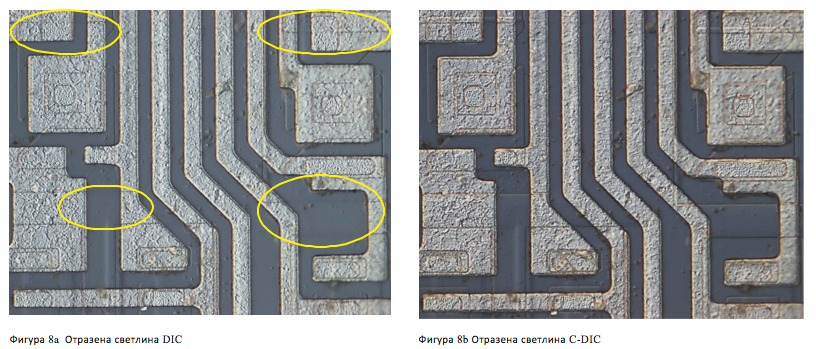
Figure 8 Полупроводникова интегрална схема / 50x обектив. Липсваща информация в DIC изображението (Сравнете информацията за означените с жълт кръг области на Фиг. 8a с тези Фиг. 8b).

Фигура 9 Предпазно термично покритие / 20x обектив. На изображението C-DIC може да се види голям дефект в повърхностното покритие, който остава скрит при изображението DIC.
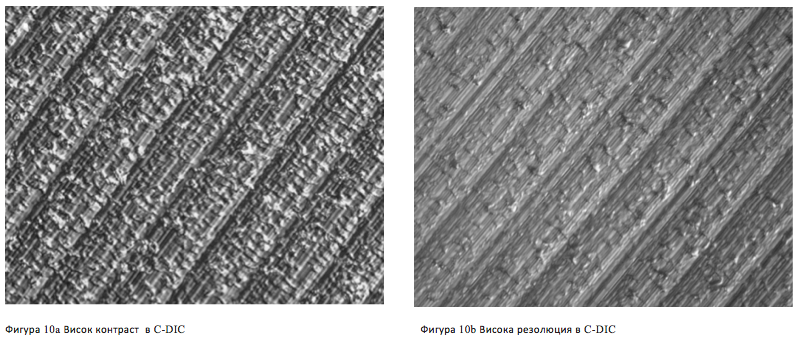
Фигура 10 Лазерно обработена повърхност (CaF2) / 100x обектив. Чрез завъртане на отместването е възмажна да се избере аптимално изображение.
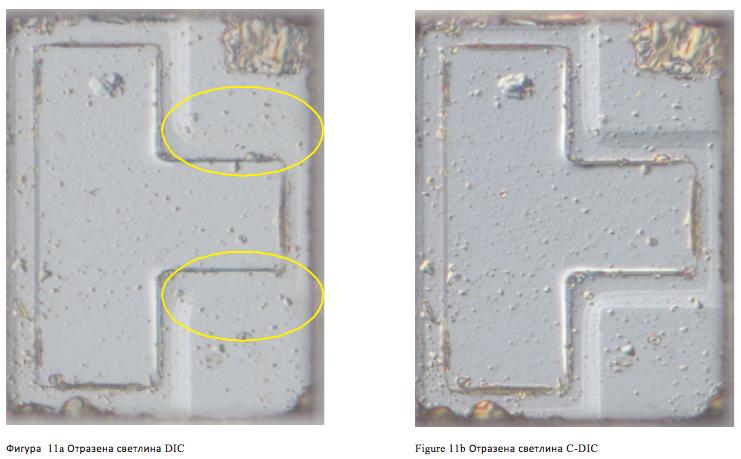
Figure 11 Чип / 50x обектив. Страничните стени на чипа се виждат ясно в изображението C-DIC. Изображението DIC може да доведе до погрешната интерпретация,че такива стени линсват.

Фигура 12 Лазерно разрушено прозрачно покритие /10x обектив. Разрушаването на покритието се вижда с използването на ориентирано отместване. Този дефект може и да не се забележи при стандартния DIC.

Фигура 13 Полирано стоманено сечение с неметални включвания / 50x обектив. Чрез регулиране на ъгъла на отместване в C-DIC може да се постигне висок контраст в някои области и висока резолюция – в други.



